半导体行业背景
行业现状
2024年全球半导体市场规模预计达6202亿美元,同比增长17%,进入新一轮上行周期。中国成为增长核心引擎,集成电路市场规模预计达1865亿美元(占全球30.1%),增速领先全球。从产品结构看,逻辑芯片(GPU/FPGA/ASIC)和存储芯片分别增长21%和61.3%,受益于AI算力需求激增;而分立器件、传感器等品类出现2%-10%下滑。应用领域方面,计算(+18.4%)、通信(+17.9%)和汽车电子(+16.7%)构成三大增长支柱,仅政府采购领域同比下降20%。
技术创新呈现双轨突破:中国近三年半导体专利年均超3000件,专利占比全球领先;台积电、英特尔等企业将AI算法植入制造流程,实现故障预测和良率优化。行业竞争格局中,美国(32家)和中国大陆(23家)占据全球百强企业半数以上,中芯国际位列全球第14位。产业整合加速,2024年A股半导体并购超40起,跨界案例频现(如药企收购芯片公司)。
未来趋势
技术突破:3纳米及以下先进制程将持续提升芯片性能,量子计算、神经形态芯片等颠覆性技术进入实用化探索,氮化镓/碳化硅等第三代半导体在新能源、轨道交通领域加速替代。
需求驱动:AI芯片市场2025年规模将达数百亿美元(CAGR>30%),5G基站、物联网传感器、车规级MCU芯片需求激增,智能汽车单机芯片价值较传统燃油车提升5-8倍。消费电子领域,AR/VR设备推动新型显示驱动芯片增长。
产业变革:垂直整合与全球化协作并行。国内企业通过并购强化设计-制造-封测协同,政策驱动下国产芯片自给率目标提升至70%。全球供应链布局呈现区域化特征,企业通过多源采购、数字孪生技术增强抗风险能力。
风险提示:地缘政治影响短期供应链稳定性,数据安全合规要求推高研发成本,全球半导体人才缺口扩大至200万人。企业需构建技术储备(如Chiplet异构集成)、深化产学研合作以应对挑战。
半导体行业产业链
上游
半导体材料:是晶圆制造与芯片封装的基础,其性能影响最终产品质量性能。包括硅片、光刻胶、电子特气、CMP 抛光材料等,其中硅片占比最大。硅材料、工艺化学品、光掩膜是晶圆制造材料前三大品类,而 CMP 抛光材料、光刻胶和电子气体等是国产薄弱环节。
半导体设备:是产业链的关键支撑,包括氧化炉、涂胶显影设备、光刻机、刻蚀机等,技术进步反向推动产业发展。前道晶圆加工的主要工序如光刻、刻蚀和薄膜沉积等,对晶圆加工精度要求极高,设备价格高昂。全球半导体设备市场被美日荷垄断,不过近年来北方华创、中微公司等国产厂商在部分领域已取得突破。
EDA 工具与 IP 核:EDA 工具是 “芯片之母”,连接设计和制造环节,分为用于模拟电路设计和数字电路设计的工具等,主要用于晶圆厂工艺平台开发、fabless 厂电路设计和晶圆厂制造测试环节等。而 IP 核是指集成电路中预先设计好的具有特定功能的模块,可被重复使用,能有效缩短芯片设计周期、提高设计效率。
中游
集成电路设计:是产业链的核心,创新能力决定产品市场竞争力,设计人员需考虑性能、功耗、成本等多方面问题,设计出各种复杂算法和架构方案。
晶圆制造:将设计转化为实际产品的关键步骤,需高度精密设备和工艺,从晶圆裸片到芯片成品,要经过氧化、溅镀、光刻、刻蚀、离子注入及封装等上百道特殊工艺步骤。
封装测试:保证芯片质量和可靠性的最后一道工序,对于提高产品的市场接受度意义重大,主要是把制造好的裸芯片进行保护和功能整合,使其能安装到各种电子设备中。
下游
涵盖消费电子、移动通信、新能源、人工智能、航空航天、汽车电子、计算机、工业应用等多个领域,随着科技发展,应用领域还在不断拓宽,市场需求持续增长,新兴技术的兴起更是促使半导体产品需求量呈现爆发式增长。
行业痛点+规划蓝图
客户要求有体系,当流程和数据都有体系规模的时候,才可以吸引到更多的客户,所以流程标准化,数据沉淀对于企业的商业模式也至关重要。
行业痛点
研发管理:
- 技术复杂性高:半导体产品研发涉及到多种前沿技术和学科,如物理学、化学、材料科学、电子工程等,需要不同专业背景的人员协同合作。不同技术环节之间的耦合度高,一个环节的问题可能影响整个研发进程,导致研发周期延长。
- 研发资源调配难:研发过程中需要投入大量的人力、物力和财力资源,包括高端设备、专业人才、研发资金等。如何合理分配和管理这些资源,确保各个研发项目的顺利进行,是企业面临的挑战之一。特别是在多项目并行的情况下,容易出现资源冲突和浪费的现象。
数据管理:
- 数据量大且分散:从芯片设计、制造到测试等各个环节,都会产生海量的数据,包括设计图纸、工艺参数、测试结果等。这些数据分散在不同的部门和系统中,形成了数据孤岛,导致数据难以共享和协同使用,影响了研发和生产的效率。
- 数据安全与合规性要求高:半导体行业涉及到大量的知识产权和商业机密,数据的安全性至关重要。同时,企业还需要遵守严格的法规和标准,如数据保护法规、出口管制规定等,确保数据的合规使用和管理。
质量管理:
- 质量标准严格:半导体产品的质量要求极高,任何微小的缺陷都可能导致产品失效,影响整个系统的性能和可靠性。因此,企业需要建立严格的质量控制体系,对原材料、生产工艺、设备等进行全方位的质量监控。
- 质量追溯困难:半导体产品的生产过程复杂,涉及到多个工序和环节,一旦出现质量问题,很难快速准确地追溯到问题的根源,增加了质量改进的难度和成本。
供应链管理:
- 供应链长且复杂:半导体行业的供应链涵盖了从原材料供应商、设备制造商、芯片设计企业、晶圆代工厂到封装测试厂商等多个环节,涉及到全球范围内的众多企业和合作伙伴。协调和管理这样一个复杂的供应链体系,确保原材料的稳定供应、生产计划的同步以及产品的及时交付,是一项艰巨的任务。
- 供应风险高:部分关键原材料和设备依赖进口,面临着供应中断、价格波动等风险,特别是在当前国际贸易形势不稳定的背景下,这种风险更加凸显。此外,自然灾害、政治因素等也可能对供应链造成冲击,影响企业的正常生产。
人才管理:
- 专业人才短缺:半导体行业是一个技术密集型行业,对专业人才的需求旺盛。然而,由于行业的专业性强、培养周期长,导致专业人才供不应求,尤其是在一些新兴领域和关键技术环节,人才短缺问题更加突出,限制了企业的技术创新和发展速度。
- 人才竞争激烈:全球半导体企业对优秀人才的竞争激烈,企业不仅需要提供有竞争力的薪酬待遇,还需要创造良好的工作环境和发展空间,以吸引和留住人才。否则,容易导致人才流失,影响企业的核心竞争力。
市场与客户管理:
- 市场需求波动大:半导体市场受宏观经济、消费电子周期、技术创新等多种因素的影响,需求波动较大。企业需要准确预测市场需求的变化,及时调整生产计划和产品布局,以应对市场的不确定性,避免库存积压或缺货现象的发生。
- 客户需求多样化:不同客户对半导体产品的性能、功能、可靠性等方面有不同的要求,企业需要具备快速响应客户需求的能力,提供定制化的产品和解决方案。同时,还需要加强客户关系管理,提高客户满意度和忠诚度。
成本控制:
- 研发与生产成本高:半导体行业的研发和生产成本高昂,从芯片设计到量产,需要投入大量的资金用于技术研发、设备购置、生产线建设等。随着技术的不断进步和市场竞争的加剧,企业还需要不断投入资金进行技术升级和产品创新,进一步增加了成本压力。
- 成本控制难度大:由于半导体产品的生产过程复杂,涉及到多个环节和因素,成本控制难度较大。企业需要在保证产品质量和性能的前提下,通过优化生产工艺、提高生产效率、降低原材料采购成本等方式,降低生产成本,提高产品的市场竞争力 。
数字化蓝图规划
企业级数字化蓝图
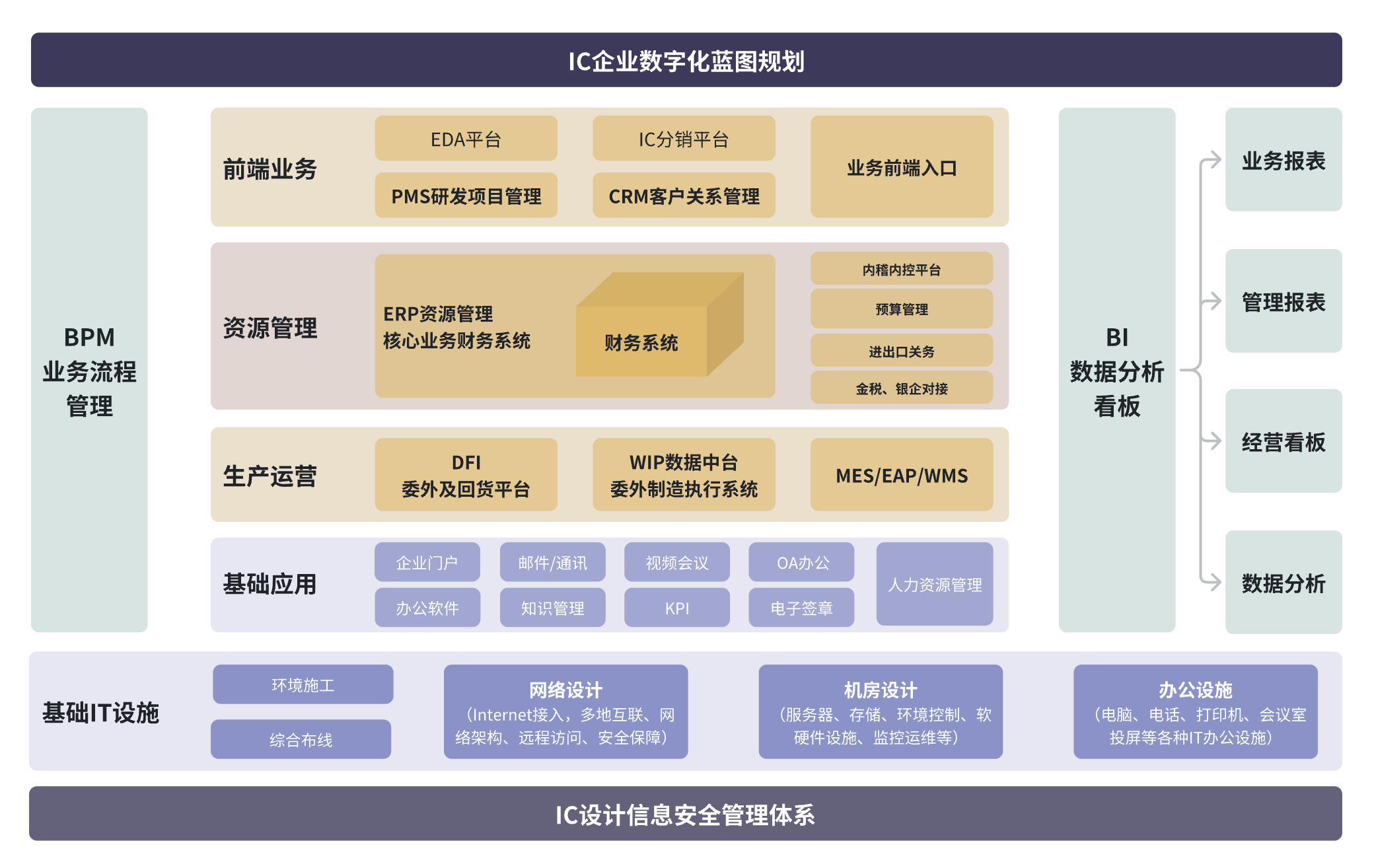
业务流程级数字化蓝图

飞书项目半导体 IPD 场景解决方案
IPD过程逻辑

飞书项目实现逻辑框架图
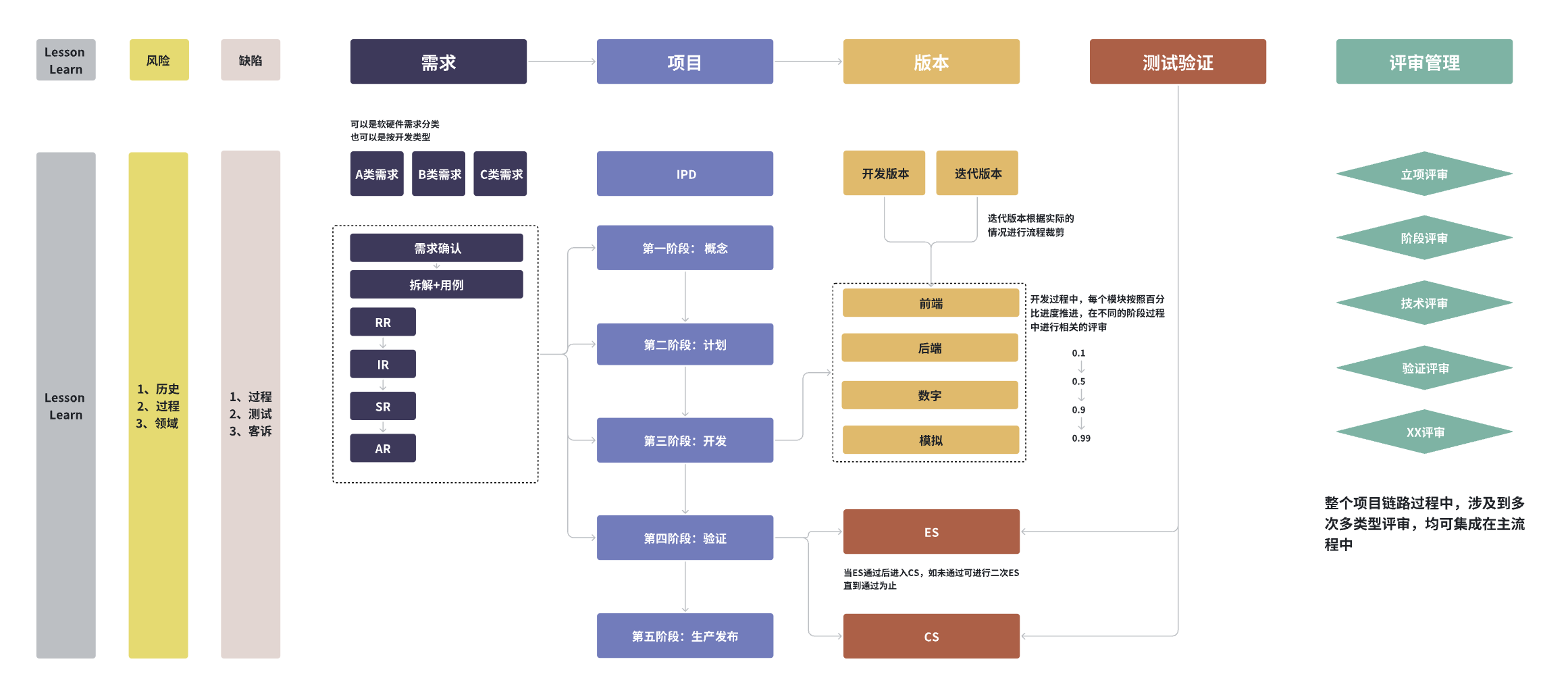
飞书项目其他场景解决方案
客户管理:如企业自己有CRM系统,此部分可考虑集成;此部分主要管理客户以及关键联系人信息等;通过与项目关联记录客户发起的项目数量,方便追踪具体项目,以及对应具体风险缺陷等。
需求管理:详见上方4.3模块;客户发起需求后承接并分析拆解,进行可行性评估后正式立项,在项目过程中进行设计、开发和验证。
缺陷管理:在设计、开发、验证和售后(客诉)阶段,均可发起缺陷管理,不同阶段/类型的缺陷可能导致流程的差异,可通过类型或者条件控制流程节点,从而实现流程差异化管理,更贴合业务。
风险管理:基本可以囊括3种风险管理模式
- 固定评估-项目阶段进行整体风险评估(技术、质量和进度等多项评估)
- 过程评估-过程中项目本身发生的风险进行记录处理,最后评估是否进入风险库作为通用风险
- 历史评估-将同类型的历史项目风险纳入近新项目进行风险比对
评审管理:各里程碑阶段以及技术点均涉及评审,如涉及IOS、VDA6.3或者AEC-Q100等认证,还需额外加入相关评审要素表进行一一查验,保证满足质量要求
变更管理:过程中无论项目进度(排期)、范围或成本等发生变更,均需要被记录以便追踪相关信息,实现风险管控